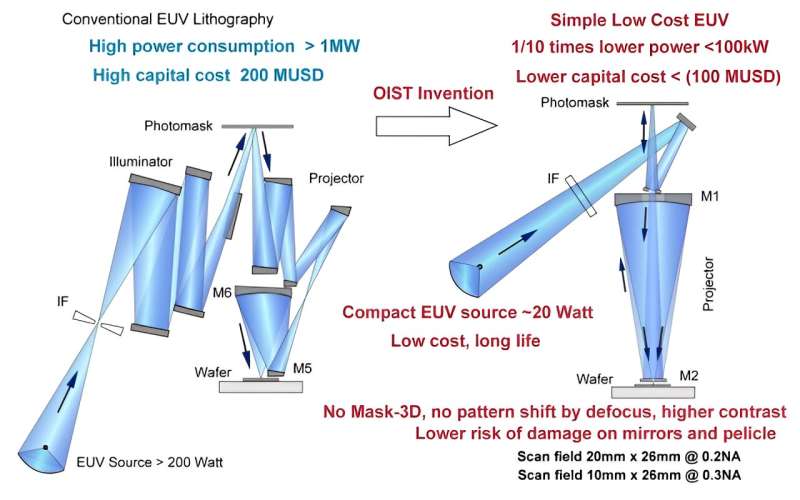
沖縄科学技術大学(OIST)の新竹勉教授は、半導体製造の標準を超える極端紫外(EUV)リソグラフィー技術を提案した。EUVリソグラフィー
この設計に基づいた装置は、より小型の EUV 光源で動作できるため、コストが削減され、機械の信頼性と寿命が劇的に向上します。また、消費電力は従来の EUV リソグラフィー装置の 10 分の 1 以下であり、半導体産業がより環境的に持続可能なものになるのに役立ちます。この技術は、これまでこの分野では解決不可能と考えられていた2つの課題を解決することで可能になりました。
1 つ目は、2 つのミラーのみからなる新しい光学投影システムを使用します。2 つ目は、平面ミラー (フォトマスク) 上のロジック パターンに EUV 光を効率的に照射する新しい方法です。光路。
EUVリソグラフィーを取り巻く課題
作っているプロセッサー人工知能(AI) が可能な低電力チップを使用モバイルデバイス携帯電話などの日常生活に欠かせない機器に使用される高密度DRAMメモリなど、これらの先進的な半導体チップはすべてEUVリソグラフィーを用いて製造されています。しかし、半導体の製造は、高電力消費と装置の複雑さという課題を抱えており、設置、メンテナンス、電力消費のコストが大幅に増加します。
新竹教授は「本発明は、これらのあまり知られていない問題をほぼ完全に解決できる画期的な技術」と語る。
カメラ、望遠鏡、従来の紫外線リソグラフィーなどの従来の光学システムでは、絞りやレンズなどの光学部品が直線上に軸対称 (中心軸に対して対称) に配置されます。この構成により、光学収差を最小限に抑えた最高の光学性能を確保し、高画質な画像を実現します。ただし、これは EUV 光線には当てはまりません。EUV 光線は波長が非常に短く、ほとんどの物質に吸収されるため、透明なレンズを通過することができません。
このため、EUV 光は、光路に沿って光線を反射し、空間をジグザグに通過する三日月形のミラーを使用して方向付けられます (下の図を参照)。ただし、この方法では光が中心軸から逸れるため、重要な光学特性が犠牲になり、システム全体のパフォーマンスが低下します。
この問題に対処するために、この新しいリソグラフィー技術は、小さな中心穴を備えた 2 つの軸対称ミラーを直線上に配置することで、優れた光学特性を実現します。
消費電力の大幅削減
EUV エネルギーは、吸収率が非常に高いため、鏡で反射するたびに 40% 弱まります。業界標準では、EUV 光源からのエネルギーのわずか約 1% が、使用される 10 枚のミラーを通ってウェーハに到達します。これは、非常に高い EUV 光出力が必要であることを意味します。この需要に応えるために、CO2EUV光源のレーザー駆動には大量の電力と冷却用の水が必要となります。
対照的に、EUV 光源からウェーハまでのミラーの数を合計 4 つに制限することで、エネルギーの 10% 以上が透過します。つまり、出力が数十ワットの小型 EUV 光源でも十分に動作できることになります。同様に効果的に。これにより、電力使用量が大幅に削減される可能性があります。
2 つの課題を克服
EUVリソグラフィーの中心となる投影機は、フォトマスクの像をシリコンウエハー上に転写するもので、天体望遠鏡と同様に2枚の反射鏡のみで構成されています。
「従来のプロジェクターでは少なくとも 6 枚の反射ミラーが必要だったことを考えると、この構成は想像を絶するほど単純です。これは、光学の収差補正理論を慎重に再考することによって可能になりました。これは、以前の古典物理学の勝利です。」量子物理学」と新竹教授は説明します。
「光学シミュレーションソフト(OpTaliX)により性能が検証されており、先端半導体の製造に十分な性能であることが保証されています。」
新竹教授は、光路を妨げずに平面ミラーのフォトマスクに正面からEUV光を照射する「デュアルラインフィールド」と呼ばれる新しい照明光学系を考案し、この問題を解決した。
新竹教授は、「2つの懐中電灯を両手に1つずつ持ち、同じ角度で目の前の鏡に向けて斜めに向けると、一方の懐中電灯の光は必ず反対側の懐中電灯に当たります。これはリソグラフィーでは受け入れられません」と説明します。しかし、懐中電灯の角度を変えずに、両側から真ん中が完全に照らされるまで手を外側に動かすと、反対側の懐中電灯の光と衝突することなく光を反射することができます。」
2 つの光源は対称的に配置され、同じ角度でマスクを照明するため、平均してマスクは正面から照明されます。これにより、マスクの 3D 効果も最小限に抑えられます。
新竹教授は、「一見不可能に思えるかもしれないが、一度解決すると非常に簡単になるという点で、コロンブスの卵のようなものです」と説明する。
この技術はOISTが特許出願しており、実証実験を通じて実用化が期待されています。「世界のEUVリソグラフィ市場は、2024年の89億ドルから2030年には174億ドルに成長すると予想されており、年平均成長率は約12%です。この特許は多大な経済的利益を生み出す可能性を秘めています。」と新竹教授は総括します。。
OIST理事副学長でOISTイノベーションリーダーのギル・グラノー・メイヤー氏は、「OISTは、人類に影響を与える最先端の科学の創造に取り組んでいます。このイノベーションは、不可能を探究し、独自のソリューションを提供するというOISTの精神を体現しています。」と述べています。
「この技術の開発にはまだ長い道のりがありますが、私たちはそれに全力を尽くしています。沖縄のこの技術が半導体産業に変革的な影響を与え、エネルギー消費や脱炭素化などの世界的な問題の解決に役立つことを願っています。」」
引用:革新的な極端紫外リソグラフィー技術が半導体製造に劇的に利益をもたらす (2024年7月29日)2024 年 7 月 29 日に取得https://techxplore.com/news/2024-07-extreme-ultraviolet-lithography-technology-benefits.html より
この文書は著作権の対象です。個人的な研究や研究を目的とした公正な取引を除き、書面による許可なく一部を複製することができます。コンテンツは情報提供のみを目的として提供されています。
