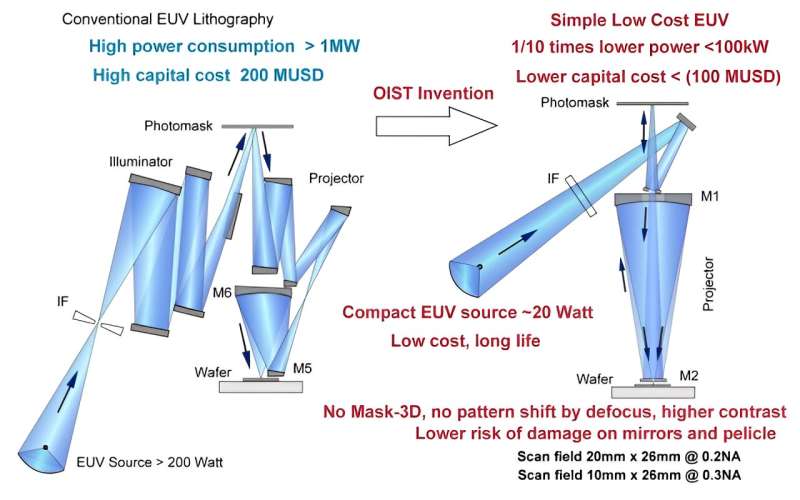
El profesor Tsumoru Shintake del Instituto de Ciencia y Tecnología de Okinawa (OIST) ha propuesto una tecnología de litografía ultravioleta extrema (EUV) que supera el estándar en la fabricación de semiconductores.EUVlitografía
Los basados en este diseño pueden funcionar con fuentes de luz EUV más pequeñas, lo que reduce los costos y mejora drásticamente la confiabilidad y la vida útil de las máquinas.También consume menos de una décima parte de la energía de las máquinas de litografía EUV convencionales, lo que ayuda a que la industria de los semiconductores sea más sostenible desde el punto de vista medioambiental.Esta tecnología ha sido posible solucionando dos cuestiones que antes se consideraban insuperables en este campo.
El primero se refiere a un novedoso sistema de proyección óptica compuesto por sólo dos espejos.El segundo implica un nuevo método para dirigir eficientemente la luz EUV hacia patrones lógicos en un espejo plano (la fotomáscara) sin bloquear lacamino óptico.
Desafíos que rodean la litografía EUV
Los procesadores que fabricaninteligencia artificial(AI) posibles chips de bajo consumo utilizados endispositivos móvilescomo teléfonos móviles y memoria DRAM de alta densidad utilizada en máquinas que se han vuelto indispensables en nuestra vida diaria: todos estos chips semiconductores avanzados se fabrican utilizando litografía EUV.Sin embargo, la producción de semiconductores se ve desafiada por el alto consumo de energía y la complejidad del equipo, lo que aumenta drásticamente el costo de instalación, mantenimiento y consumo de energía.
Como dice el profesor Shintake: "Este invento es una tecnología innovadora que puede resolver casi por completo estos problemas poco conocidos".
En los sistemas ópticos tradicionales, como cámaras, telescopios y litografía ultravioleta convencional, los componentes ópticos como la apertura y las lentes están dispuestos axialmente (simétricos con respecto al eje central) en línea recta.Esta configuración asegura el máximo rendimiento óptico, con mínimas aberraciones ópticas, consiguiendo imágenes de alta calidad.Sin embargo, esto no funciona con los rayos EUV, ya que tienen longitudes de onda extremadamente cortas que son absorbidas por la mayoría de los materiales, lo que significa que no pueden viajar a través de lentes transparentes.
Por esta razón, la luz EUV se dirige mediante espejos en forma de media luna que reflejan los rayos a lo largo del camino óptico en un patrón de zigzag a través del espacio abierto (consulte la ilustración a continuación).Sin embargo, debido a que este método hace que la luz se desvíe del eje central, sacrifica importantes propiedades ópticas y reduce el rendimiento general del sistema.
Para combatir este problema, esta nueva tecnología de litografía logra sus propiedades ópticas superiores alineando dos espejos axisimétricos con pequeños orificios centrales en línea recta.
Reducción significativa del consumo de energía.
La energía EUV se debilita en un 40% con cada reflejo en el espejo debido a su muy alta absorbencia.Según el estándar de la industria, sólo alrededor del 1 % de la energía de la fuente de luz EUV llega a la oblea a través de los 10 espejos utilizados, lo que significa que se requiere una salida de luz EUV muy alta.Para satisfacer esta demanda, el CO2El accionamiento láser para la fuente de luz EUV requiere una gran cantidad de energía eléctrica, así como una gran cantidad de agua para enfriar.
Por el contrario, al limitar el número de espejos a solo cuatro en total desde la fuente EUV hasta la oblea, más del 10% de la energía pasa, lo que significa que incluso una pequeña fuente EUV con una potencia de unas pocas decenas de vatios puede funcionar apenascon la misma eficacia.Esto puede conducir a una reducción significativa en el uso de energía.
Dos desafíos superados
El proyector central de la litografía EUV, que transfiere la imagen de la fotomáscara a la oblea de silicio, consta de sólo dos espejos reflectantes, como un telescopio astronómico.
"Esta configuración es inimaginablemente simple, dado que los proyectores convencionales requieren al menos seis espejos reflectantes. Esto fue posible repensando cuidadosamente la teoría de la corrección de la aberración óptica. Es un triunfo de la física clásica antesfísica cuántica", explica el profesor Shintake.
"El rendimiento se ha verificado mediante el software de simulación óptica (OpTaliX) y se garantiza que es suficiente para la producción de semiconductores avanzados".
El profesor Shintake resolvió el problema ideando un nuevo método de iluminación óptica, denominado "campo de línea dual", que irradia una fotomáscara de espejo plano con luz EUV desde el frente sin interferir con la trayectoria óptica.
El profesor Shintake explica: "Si sostienes dos linternas, una en cada mano, y las apuntas diagonalmente a un espejo frente a ti en el mismo ángulo, entonces la luz de una linterna siempre incidirá en la linterna opuesta, lo cual es inaceptable en litografía."Pero si mueves las manos hacia afuera sin cambiar el ángulo de las linternas hasta que el centro esté perfectamente iluminado desde ambos lados, la luz puede reflejarse sin chocar con la luz de las linternas opuestas".
Dado que las dos fuentes de luz están situadas simétricamente e iluminan la máscara en el mismo ángulo, la máscara se ilumina en promedio desde delante.Esto también minimiza los efectos de máscara 3D.
"Es como el huevo de Colón", explica el profesor Shintake, "en el sentido de que puede parecer imposible a primera vista, pero una vez resuelto, resulta muy sencillo".
La OIST ha presentado una solicitud de patente para esta tecnología y se espera que se ponga en práctica mediante experimentos de demostración."Se espera que el mercado mundial de litografía EUV crezca de 8.900 millones de dólares en 2024 a 17.400 millones de dólares en 2030, con una tasa de crecimiento anual promedio de aproximadamente el 12%. Esta patente tiene el potencial de generar enormes beneficios económicos", resume el profesor Shintake..
Gil Granot-Mayer, vicepresidente ejecutivo de OIST y líder de Innovación de OIST, dice: "OIST está comprometido a crear ciencia de vanguardia que impactará a la humanidad. Esta innovación captura el espíritu de OIST de explorar lo imposible y ofrecer soluciones originales.
"Aunque todavía nos queda un largo camino por recorrer en el desarrollo de esta tecnología, estamos comprometidos a hacerlo. Esperamos que esta tecnología de Okinawa tenga un impacto transformador en la industria de los semiconductores y ayude a resolver problemas globales como el consumo de energía y la descarbonización."
Citación:La innovadora tecnología de litografía ultravioleta extrema beneficia drásticamente la fabricación de semiconductores (2024, 29 de julio)recuperado el 29 de julio de 2024de https://techxplore.com/news/2024-07-extreme-ultraviolet-lithography-technology-benefits.html
Este documento está sujeto a derechos de autor.Aparte de cualquier trato justo con fines de estudio o investigación privados, noparte puede ser reproducida sin el permiso por escrito.El contenido se proporciona únicamente con fines informativos.
